5. 測定システムの構成
LV-1800 レーザードップラー振動計をセンサーとしたワイヤボンダ測定システムの構成としては以下のようになります。
|
|
振動子は、特定の周波数で大きな振動を発生する特性(共振周波数)がありますが、条件次第で周波数が変化することがあるため、振動子を駆動する発振器にフィードバック回路を設けて周波数制御をおこなっています。また、金属ホーンを伝搬した振動は増幅されることで、 ツール先端の振幅は無負荷時で数 μm 程度となります。 安定したボンディングを行うためには、ツール先端での振動振幅を安定させる必要があります。このため、ツール先端の振動をダイレクトに測定するニーズが年々増大してきています。
6. 測定の内容
ワイヤボンダ測定システムを使用した測定例の一例として以下のような測定があります。
6-1 テスト駆動時の振動値測定(静的チェック)
ワイヤボンダでは、駆動信号をテスト入力して、ツールを振動させる機能があります。 長時間使用したワイヤボンダでは、振動子やホーンに疲労が蓄積され、初期状態と違っ た振動をはじめることがあります。このため、新しい振動子やホーンに取り替えた際、 その使用初期においてホーン先端での振動値を記録しておくと、その後のホーン先端の 振動値の変化で振動子やホーンのメンテナンスを定量的に行うことができます。とくに、 駆動信号側の強度の増減に対して実際のホーン先端やツールの振動振幅が比例して増 減するかどうか測定しておくことは、その後のメンテナンスに有用なデータを提供する ものといえます。またワイヤホンダの導入時あるいはメンテナンス時において、振動子 やホーンあるいはUS 発振器をボンダメーカ純正品から専業メーカ品への変更を検討 される場合、各機器の性能を比較する際の有力な検証手段となり得ます。
6-2 ツール圧着時の振動測定(動的測定)
前述したとおり、ボンディング時のツールの振動は、従来、超音波振動子の抵抗値 の変化(インピーダンス)やエコーの測定結果から推測するだけでしたが、レーザードッ プラ振動計を使用することでボンディング中の実際のツールの振動からボンダビリテ ィの検証が可能となります。 ただし、レーザー光をボンディングに追従して当てることが難しいため、ワイヤボンダが連 続してボンディング動作をしている状況下(オートボンディング)での測定はできませ ん。1回だけ単発的にボンディングできる機能(マニュアルボンディング)を使用する ことで、ボンディングの瞬間でのツールの挙動を測定することができます。
ツールを実際にチップやリードフレームに圧着させて、振動させた際の振動を測定する と、接触圧やUS の違いによる振幅変調が観測されたり、リードフレームの共振周波数 の関係から周波数変調(基本周波数の脇にサイドバンド周波数)が発生したりする状況 が観測できます。 またツールは交換部品であるため交換作業があり、ホーンに対するツールの取付位置や 固定ネジの締め付けトルク次第では、ボンディング時にツールの振幅が変化することがあり、さらにツールの材料や形状によっても振動振幅が変化することがわかっています。
いずれにせよ、変化率の大きな測定データが得られるのはレーザードップラ方式ならでは といえますが、データ取得に伴う「ボンダビリティ評価基準」の作成は、ボンディング マシン機種・事業所など個別に設定せざるを得ないため、定期的・イベント発生時等に データ取得を行って蓄積して行く必要があります。
6-3 ツールの振動モード測定
ツールも構造物である限り、当然ながら共振周波数に起因する振動モードをもってい ます。とくに 60 kHz や 100 kHz 以上でツールが振動した際に、その長さ方向で複数点でのデータを測定していくことで、ツールの材質や形状の微妙な違いで振動モードがどのように変化するかを測定することが可能となります。 ツールの材質や形状を微妙に変更することでボンダビリティが変化することは一般的によく知られていますが、ツール表面や内面の仕上げとともにツールの共振周波数あるいは振動モードにより、ボンダビリティが左右されることがわかっています。 このため、新しい形状や材質のツールを開発・検証する際においてもレーザードップラー振動計は有益な情報を提供してくれるでしょう。
6-4 リードフレームの共振測定
1チップあたりの集積度の向上にともない、リードフレームも多ピン化あるいはファインピッチ化されてきています。 ワイヤボンディングに際しては、前述のように超音波によって加振されているため、リ ードフレームのピンが狭小化されるに従い共振現象等でボンディング中のピンの振動が他のピンに悪影響を及ぼすというケースが増加してきており、ワイヤの断線や破断と いう不良発生要因として注目されています。 振動を抑制する方法としては、2種類の方法が考えられます。 ひとつは、加振源の振動量を小さくしたり、リードフレームの共振周波数を外した周波数で振動させる方法であり、もうひとつはリードフレーム側の構造変更や制振材料等を使用して振動が伝搬しないように制振する方法です。
しかしながらワイヤボンダの場合、ボンディングの際の振動は必要不可欠であるため、 振動量を小さくしたり周波数を変更することは事実上不可能です。よって、振動を抑制する方法としては、リードフレームを設計変更して振動の伝搬を抑える方向で検討する必要があります。 構造変更や制振材料の選択に際しては、対象となるリードフレームの材料や形態によって最適な方法が変化することが考えられ、振動テストを行いながら検討することが必要不可欠となります。
キャピラリの先端に形成されたワイヤ端のボールはキャピラリの下降に伴いチップ上に形成されたパッドと言うチップ上の接合面に押しつけられ接合します。次にキャピラリはワイヤを繰り出しながらリード上に移動し同様に接合します。その後キャピラリは上昇し、その際クランプが閉じることでワイヤーがカットされます。カットされたワイヤ端にトーチより高圧放電されることでワイヤ端が溶融し再度ボールが形成されます。 この時の IC パッドへのボンディングを第1ボンド、リードへのボンディングを第2ボンドといいます。 ワイヤボンディングの際のボンディングパラメーターには以下のものがあり、第1・第2 個別に設定できるようになっています。
7. まとめ
ワイヤボンディングの工程における超音波融着に関して、学術的なアプローチでの解析・検証は、一部を除いて現在まであまり行われていません。 実際の製造現場においては、ボンディングについて過去の経験則からの継続というアプ ローチが今もって主流であり、経験則で事なきを得ている場合も少なくありません。しかしながら、これからのワイヤボンディングには新しい材料を使用した IC や多ピン・ 狭ピッチ化あるいはワイヤボンダ側の高速・高周波化等、不確定要素がますます増大していくことは明白であり、超音波融着に関する学術的な解析・検証は、ワイヤボンダメーカのみならず各種デバイスを製造するデバイスメーカにも求められてくるものと思われます。これら「ワイヤボンディングプロセスのインテリジェント化」第一歩として、 レーザードップラー振動計による測定をお奨めします。
●プリントアウトデータ
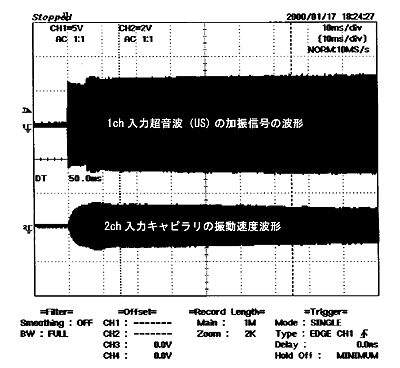
●ズーム処理したデータ